 先進的HDI PCBs
先進的HDI PCBs
高可靠性高階高密度互聯技術(HDI)產品量產
- 高達16層任意層間互聯
- 線寬 / 間距:40/40um
- 超小間距焊球陣列封裝 (BGA)設計
- 高達77G Hz的高速材料混壓高密度互聯(HDI)產品
- 厚銅、埋銅塊以及創新散熱解決方案


 先進的HDI PCBs
先進的HDI PCBs
高可靠性高階高密度互聯技術(HDI)產品量產
高達16層任意層間互聯
線寬 / 間距:40/40um
超小間距焊球陣列封裝 (BGA)設計
高達77G Hz的高速材料混壓高密度互聯(HDI)產品
厚銅、埋銅塊以及創新散熱解決方案
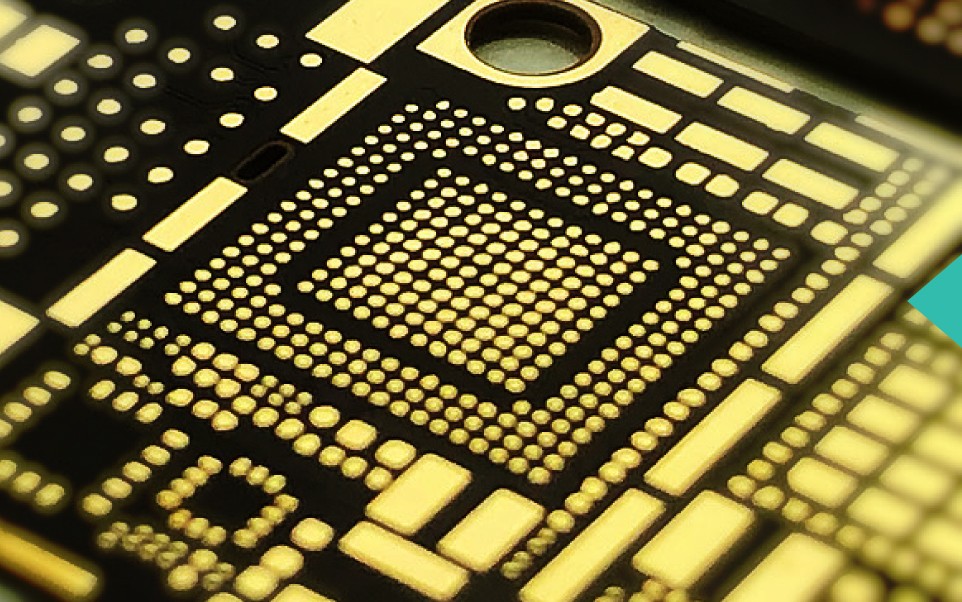
 類載板(SLP)印製電路板(PCBs)
類載板(SLP)印製電路板(PCBs)
高可靠性類載板(SLP)產品
- 採用半加成(mSAP)技術
- 線寬/線距可以達到30/30微米
- 超小間距扇出型晶元
- 針對超大引腳數量的封裝設計
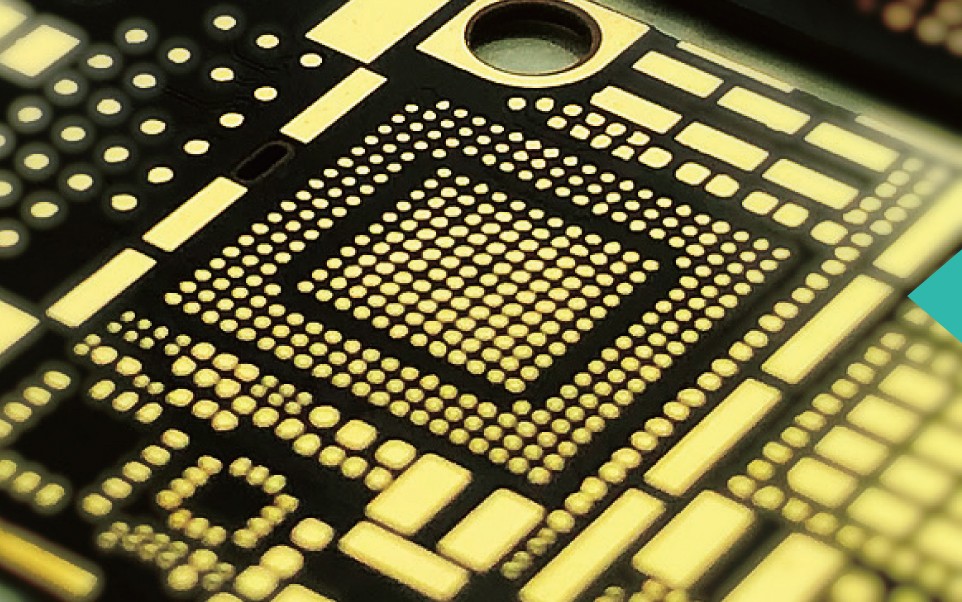
 類載板(SLP)印製電路板(PCBs)
類載板(SLP)印製電路板(PCBs)
採用半加成(mSAP)技術的高可靠性類載板(SLP)產品
(SLP) products with Modified Semi-Additive (mSAP) technology
線寬/線距可以達到30/30微米
超小間距扇出型晶元
針對超大引腳數量的封裝設計
 半導體封裝基板
半導體封裝基板
超薄及高度定制的封裝模塊基板
- 線寬線距可達 20/40微米減成法及20/30微米半加成法
- 150微米節距倒裝晶片
- <0.2mm 6L有芯板/無芯板(Coreless)封裝基板
- 超低熱膨脹係數(CTE)BT / FR5材料、低損耗材料以及LED模組應用材料
- 帶空腔的2.5維封裝(2.5 D)、嵌入式圖形線路、分散式埋容埋阻
- SOP植球工藝(SOP技術)


 半導體封裝基板
半導體封裝基板
超薄及高度定制的封裝模塊基板
線寬線距可達 20/40微米減成法及20/30微米半加成法
150微米節距倒裝晶片
<0.2mm 6L有芯板/無芯板(Coreless)封裝基板
超低熱膨脹係數(CTE)BT / FR5材料、低損耗材料以及LED模組應用材料
帶空腔的2.5維封裝(2.5 D)、嵌入式圖形線路、分散式埋容埋阻
SOP植球工藝(SOP技術)

 柔性 /柔性組裝 /剛性和柔性高端HDI PCBs
柔性 /柔性組裝 /剛性和柔性高端HDI PCBs
高密度互聯柔板/柔板組裝/剛柔結合印製線路板
- 高階高密度互聯(HDI)及任意層間互聯柔板/柔板組裝/剛柔結合板
- 線寬 / 間距:40/40um
- 超小節距晶片
- 超薄12微米厚度聚醯亞胺(PI)軟板、10微米厚度保護膜(Coverlay)
- 動態彎折/安裝彎折及半柔性軟硬結合板(Semi-flex)
- 支持對稱及非對稱結構
- 聚醯亞胺和低損耗改良聚醯亞胺 /液晶高分子聚合物(MPI / LCP)物料
- 客制化組裝及測試

 Flex / Flex-assembly / Rigid Flexible (HDI) PCBs
Flex / Flex-assembly / Rigid Flexible (HDI) PCBs
高密度互聯柔板/柔板組裝/剛柔結合印製線路板
高階高密度互聯(HDI)及任意層間互聯柔板/柔板組裝/剛柔結合板
線寬 / 間距:40/40um
超小節距晶片
超薄12微米厚度聚醯亞胺(PI)軟板、10微米厚度保護膜(Coverlay)
動態彎折/安裝彎折及半柔性軟硬結合板(Semi-flex)
支持對稱及非對稱結構
聚醯亞胺和低損耗改良聚醯亞胺 /液晶高分子聚合物(MPI / LCP)物料
客制化組裝及測試

