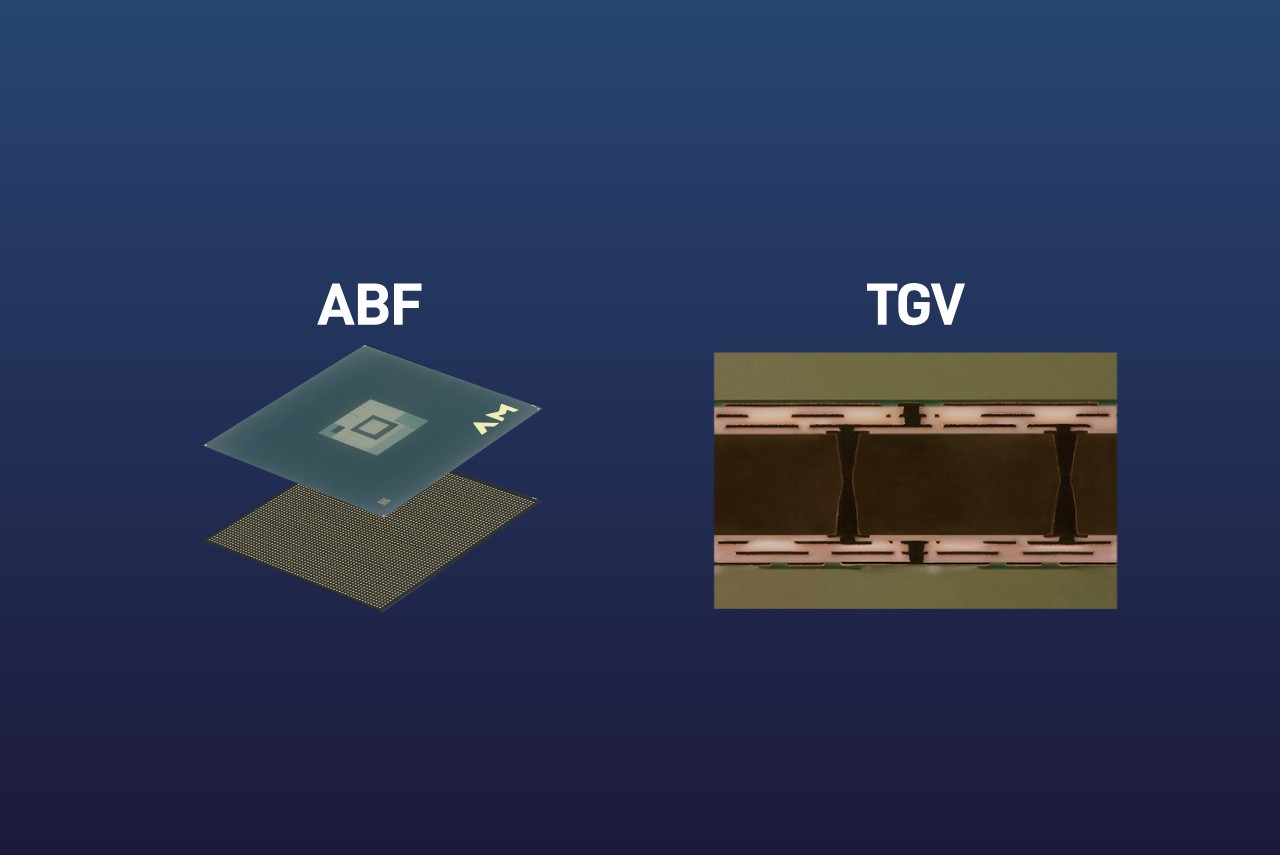
 ABF & TGV 載板
ABF & TGV 載板
ABF 載板
- 尺寸 最大110 x 110mm
- 結構 最大10+N+10
- Bulidup Layer Via/Pad Size (um) Min.50/75
- Bulidup 增層 線寬/線距 間距(um)最小 8/8
- 錫球間距(um)最小90
TGV 載板
- 廈門工廠可對應12+2+12打樣
- TGV通孔孔徑100um以下
 BT Substrate
BT Substrate
- 14層任意層互聯(芯板/無芯板結構)
- 線寬 / 間距:
・Subtractive: 20/25 um
・mSAP: 12/18 um
・ETS: 12/12 um sample - 130um 節距倒裝芯片 CSP/BGA
- 板厚小于0.2mm的6層載板(芯板/無芯板結構)
- 超低CTE,低損耗BT/FR5 材料
- 2.5D空腔,埋線(ETS:Embedded Trace Substrates),薄膜埋容埋阻技術
- 植球技術:SOP( 含print & microball)


 先進的HDI PCBs
先進的HDI PCBs
高可靠性高階高密度互聯技術(HDI)產品量產
高達16層任意層間互聯
線寬 / 間距:40/40um
超小間距焊球陣列封裝 (BGA)設計
高達77G Hz的高速材料混壓高密度互聯(HDI)產品
厚銅、埋銅塊以及創新散熱解決方案
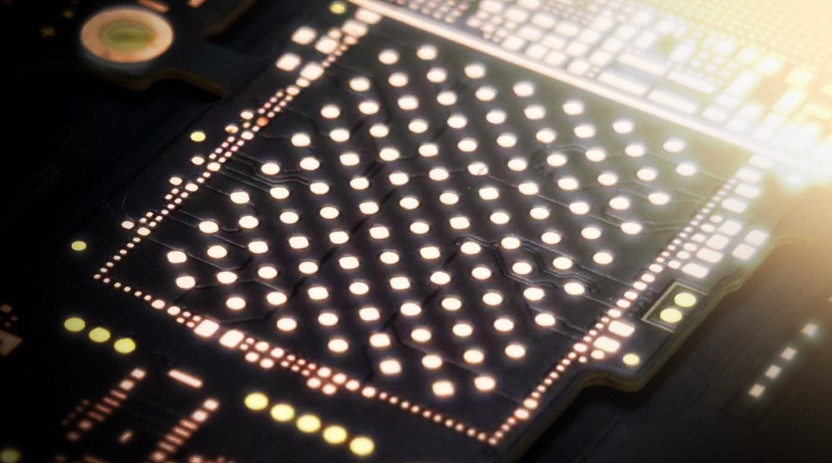
 Substrate-Like-PCB(SLP)
Substrate-Like-PCB(SLP)
- 16層任意層互連
- 110um無芯板厚度
- 線寬線距18/22 um(mSAP)
- 最小倒裝芯片距離为127um
- 下壹代超高引腳數量 / 精細節距移動裝置主板解決方案
- 空腔及2.5D結構
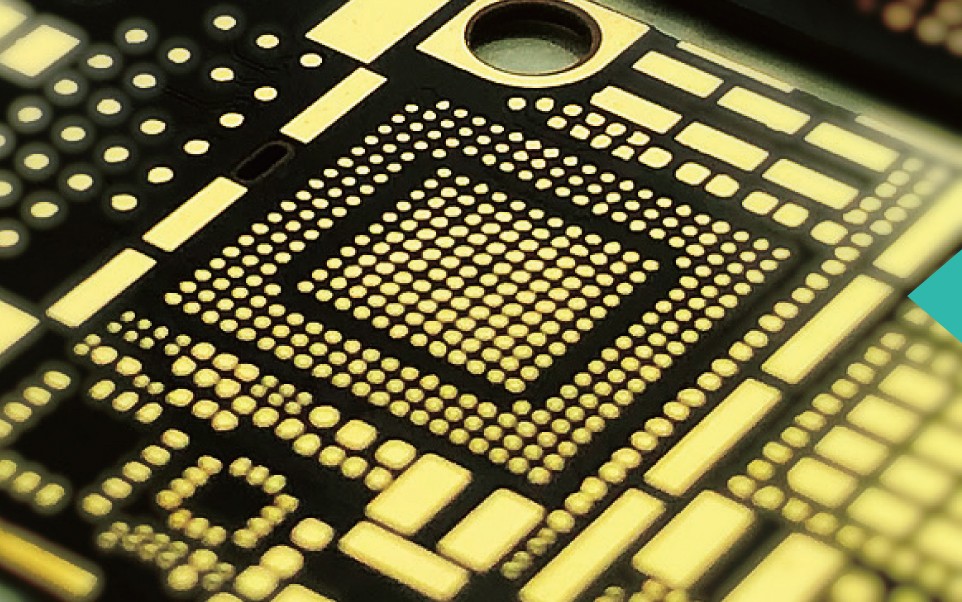
 類載板(SLP)印製電路板(PCBs)
類載板(SLP)印製電路板(PCBs)
採用半加成(mSAP)技術的高可靠性類載板(SLP)產品
(SLP) products with Modified Semi-Additive (mSAP) technology
線寬/線距可以達到30/30微米
超小間距扇出型晶元
針對超大引腳數量的封裝設計
 HDI及軟硬結合板
HDI及軟硬結合板
HDI
- 高達18層任意層互連板
- 30 /30 um L/S
- 0.3mm 精細節距BGA
- 高達77G Hz高頻材料混壓HDI
- 空腔及2.5D結構
軟硬結合板
- 高達10層柔性線路的通孔/高階HDI/任意層互連軟硬結合板
- 25 / 25 線寬線距
- 12um Pl,10um超薄覆蓋膜軟硬結合線路板
- PI/低損耗改性PI/液晶聚合物(LCP)
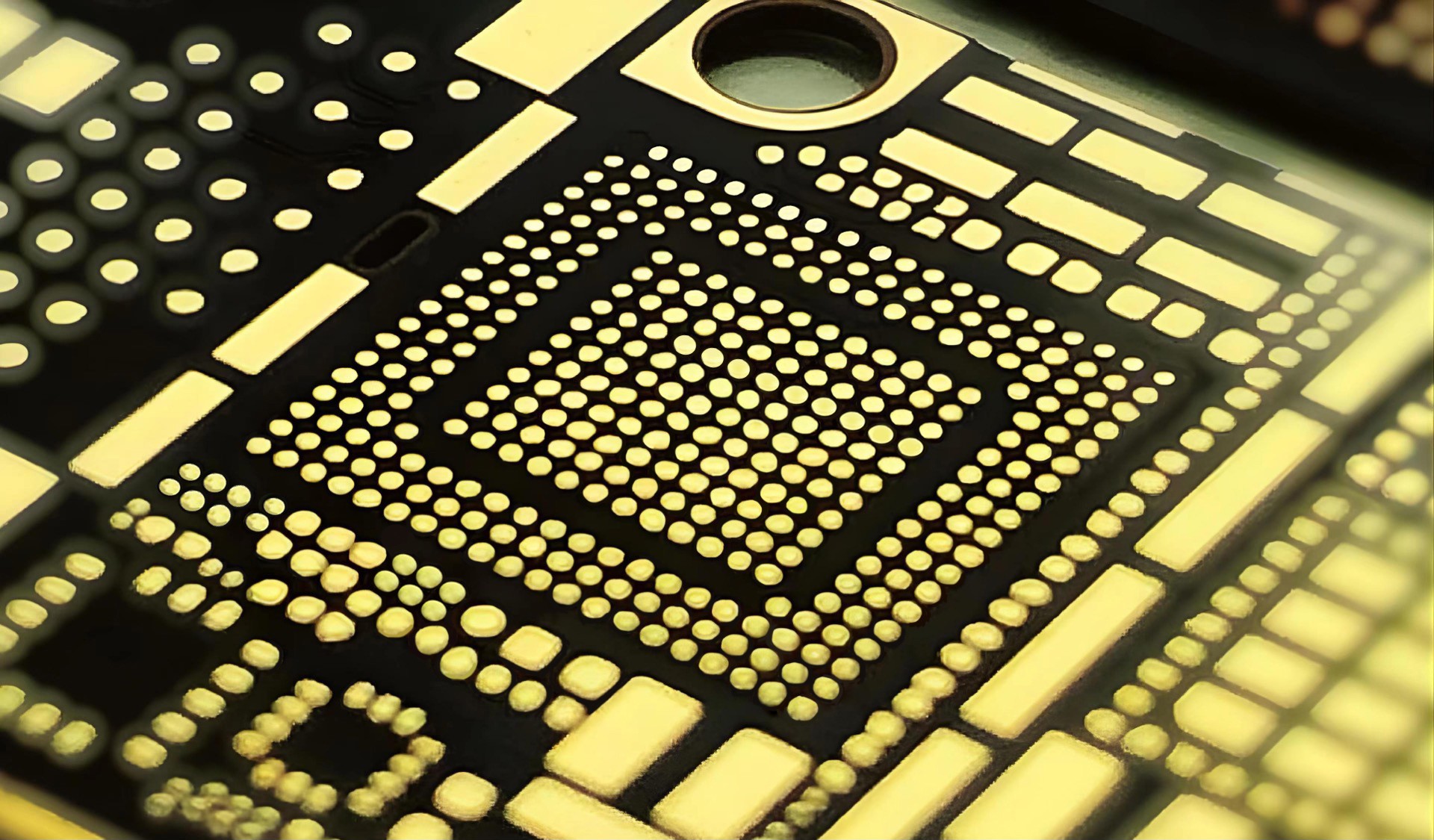

 IC載板
IC載板
超薄及高度定制的封裝模塊基板
線寬線距可達 20/40微米減成法及20/30微米半加成法
150微米節距倒裝晶片
<0.2mm 6L有芯板/無芯板(Coreless)封裝基板
超低熱膨脹係數(CTE)BT / FR5材料、低損耗材料以及LED模組應用材料
帶空腔的2.5維封裝(2.5 D)、嵌入式圖形線路、分散式埋容埋阻
SOP植球工藝(SOP技術)

 Flex & Assembly
Flex & Assembly
- 30 / 30 線寬線距
- 整板板厚:0.0.6-0.8 mm
- 0.3mm PIN Pitch (連接器及IC芯片)
- 0.35mm Pitch BGA/CSP/Flip chip
- PI / 低損耗改性PI / 液晶聚合物(LCP)
- Flex-to-Install / Dynamic bend / Semi-Flex(Bending FR4 Flex)
- 對稱 / 不對稱疊構
- 最小貼片規格:01005
 Power Battery Module (CCS)
Power Battery Module (CCS)
- FPC尺寸長達2.4米,FPCA尺寸長達2米,用于溫度和電壓采集、過電流保護。
- 連接器刺破壓接、鋁 / 銅超聲波焊接
- PET作絕緣膜的熱壓CCS,熱鉚工藝的注塑CCS
- 一站式服務,涵蓋設計開發、布局、仿真、制造、SMT、測試和組裝


 Flex / Flex-assembly / Rigid Flexible (HDI) PCBs
Flex / Flex-assembly / Rigid Flexible (HDI) PCBs
高密度互聯柔板/柔板組裝/剛柔結合印製線路板
高階高密度互聯(HDI)及任意層間互聯柔板/柔板組裝/剛柔結合板
線寬 / 間距:40/40um
超小節距晶片
超薄12微米厚度聚醯亞胺(PI)軟板、10微米厚度保護膜(Coverlay)
動態彎折/安裝彎折及半柔性軟硬結合板(Semi-flex)
支持對稱及非對稱結構
聚醯亞胺和低損耗改良聚醯亞胺 /液晶高分子聚合物(MPI / LCP)物料
客制化組裝及測試

